全球 AI 晶片需求快速升溫,帶動 ABF 載板產業復甦。近期外資更出具報告,ABF 缺口今年約 10%,2027 年將擴大至 20%,2028 年更可能達 40%,過往如記憶體一樣為景氣循環股的 ABF 這次會有怎樣的盛況呢?究竟 ABF 載板到底是什麼?為什麼會有 ABF 載板三雄?又真的確如大家所言這麼具有潛力嗎?本文中,筆者將帶領您從 ABF 基本介紹開始,並用實際財報數據去探討目前的 ABF 市場現況與展望。
編按:2026/03/16 更新,ABF 載板產業迎來結構性轉折。在歷經兩年下行週期後,市場由 AI 驅動新一輪上升週期。外資報告預測,2025 至 2030 年載板產值將以 16.1% 的 CAGR 加速,且 AI 相關應用預計在 2030 年佔據市場需求的 75% 。雖然目前仍受到原料 T-glass 供應緊張限制,但在載板大型化與多層化趨勢下,預計 2027 年起將轉為供不應求。隨著欣興、南電等台廠龍頭獲利動能轉強,產業普遍看好此波由 AI 基礎設施帶動的長期成長紅利 。
ABF 載板是什麼?
要知道 ABF 載板是什麼,或許要先從認識「IC 載板」開始!所謂「IC 載板」,就是「負責承載 IC 的零組件,是一種介於 IC 半導體及 PCB 之間的產品」,它主要有以下 2 種功能:
- 內部的線路可作為在其上方的「晶片」與在其下方的「電路板」之間連接的橋樑
- 保護電路完整,同時建立有效的散熱途徑
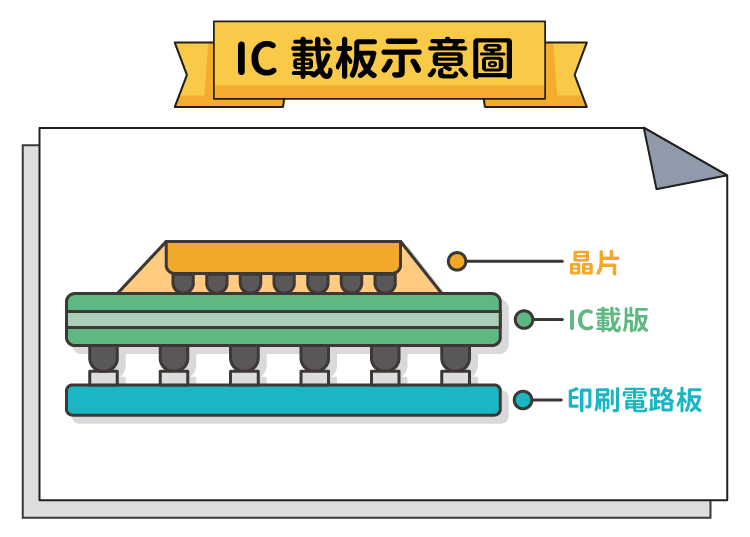
再講得更白話一點,投資朋友們可以把它概略想像成夾心餅乾的樣子,而「ABF 載板」就是兩片餅乾(半導體、PCB)之間的夾心層!講到這邊,希望投資朋友心中能對 ABF 載板的雛形有初步的認識與想像。
在了解 IC 載板的大致模樣後,讓我們一同進入今天的主題—— ABF 載板。IC 載板可以依據其「基材」的不同,再細分為 BT 載板(Bismaleimide Triacine)跟 ABF 載板(Ajinomoto Build-up Film)兩種。
| BT 載板 & ABF 載板材料與特性比較 | ||
| BT 載板 | ABF 載板 | |
| 原料 | 樹脂材料 | 專利樹脂絕緣膜 |
| 特性 | 材質硬、耐熱性高、抗潮濕 | 線路較細、適合高訊息傳輸 |
| 比較 | 目前多應用在手機、記憶體等傳統應用 | 載板特性較符合未來高階運算需求 |
▲BT 載板 & ABF 載板材料與特性比較(表格整理:股感知識庫)
在這邊做個簡單總結,ABF 載板是 IC 載板的其中一支,而相較於 BT 載板而言,ABF 基板具有較高的運算性能。
ABF 載板應用領域
從上一個段落的表格可以看出,ABF 載板應用領域與 BT 載板最大的不同,在於它較適合「高階」的運用。這個產品特性其實也可以從 10 年前的 ABF 產業衰退循環中得到驗證 —— 當時是智慧型手機剛開始起步的時期,不過那時候的手機並不需要用到很高階的運算,這也正讓之前 ABF 產業的需求量遲遲無法有效推升。
不過隨著科技日益精進,產品製程越來越先進,相關的元件、材料技術要求也越來越高。現在大家在日常耳熟能詳的幾個科技概念 —— 諸如雲端、大數據、 5G 、AI 等,全是 ABF 的主要應用領域!不難想像 ABF 載板在未來的市場確實還具有很大的成長空間。
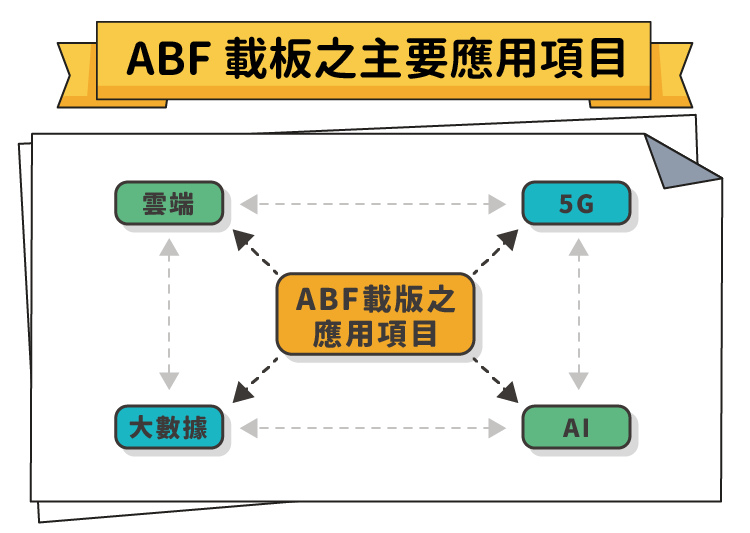
ABF 市場現況
回顧過往表現,ABF 市場也為景氣循環股,市場在 2022 年曾創下約 92.23 億美元的產值高點 ,隨後因疫情後的市場調整經歷兩年衰退。2025 年被視為產業復甦的轉折點,預計將結束低迷重回成長軌道,市場規模估計回升至 70.33 億美元 。
展望未來五年,在 AI 應用的強力驅動下,2025 年至 2030 年間的產值年複合成長率(CAGR)預計將從過去五年的 9.0% 提升至 16.1%。預計到 2030 年,全球 ABF 載板的市場總產值將較 2025 年翻倍成長,攀升至 148.11 億美元的歷史新高 。
而根據 2024 年 的營收結構(Revenue Mix)數據,全球前七大 ABF 載板供應商合計佔據市場約 85% 的份額 。包括(市占率、國家)如下表:
| 公司 | 市占率 | 國家 |
| 欣興(Unimicron) | 27% | 台灣 |
| IBIDEN | 19% | 日本 |
| AT&S | 10% | 奧地利 |
| 三星電機 (SEMCO) | 9% | 韓國 |
| 南電 (NYPCB) | 8% | 台灣 |
| 新光電工 (Shinko) | 8% | 日本 |
| 景碩 | 4% | 台灣 |
| 其他 (Others) | 15% | – |
▲ABF 市占率(資料來源:券商產業報告,股感知識庫整理)
其中欣興、南電、景碩被合稱為台灣「ABF 三雄」—— 光是 ABF 三雄合計就佔了全球 ABF 近 40% 市占率。
有趣的是,日本味之素積層膜(ABF)提供作為高效能半導體載板的關鍵絕緣材料,目前擁有超過 90% 的全球供應市佔率。除了上述傳統大廠,近期也有新進者如台灣的臻鼎以及中國的深南電路、興森科技等開始投入此市場,但目前尚未對產業供需造成顯著威脅 。
ABF 三雄
欣興( 3037-TW )
欣興於 1990 年成立,屬於聯電( 2303-TW )集團企業,股票於 2002 年上市,目前是全球 ABF 載板龍頭,也是台灣 ABF 載板三雄之中的「老大哥」—— 營收規模居三者之冠。
根據 2025Q4 營運結果,欣興全年合併營收達到新台幣 1,312.4 億元,年增 13.8% 。在產品結構上,IC 載板佔營收比重約 58%,且公司正積極減少毛利較低的中低階 BT 載板,轉而全力投入高階 ABF 生產 。法人外資也紛紛給予欣興「加碼」評等,甚至將目標價上調至 500 元,主要看好其在 AI ASIC 領域的領先供應份額,並預測 2025 至 2028 年間的獲利年複合成長率將高達 105%。
欣興的高階產能正受惠於資料中心與高效能運算(HPC)的穩健需求,特別是 AI 伺服器對大型載板的強勁拉貨力道 。
南電( 8046-TW )
南電於 1997 年成立,屬於南亞( 1303-TW )集團企業,股票於 2006 年上市,目前是台灣 ABF 載板的產值亞軍。南電 2025 年自結營收約為 401.7 億元,其中第四季營收為 111.7 億元,EPS 1.86 元,獲利能力優於市場預期。其主要成長動能來自於 800G 交換器(Switch)與新 ASIC 專案的貢獻,目前錦興廠已處於滿載狀態,樹林廠則預計在 2026 年第一季通過客戶認證後也將達到滿載 。南電積極優化產品組合,預期隨價格結構改善與產能利用率提升,毛利率與營業利益率將在 2026 年持續擴張 。
景碩( 3189-TW )
景碩於 2000 年成立,屬於和碩( 4938-TW )集團企業,股票於 2004 年上市,是台灣國內第三大的 ABF 載板廠。雖然景碩在 2024 年全球市場佔有率約為 4% ,營收規模相對較小,但同樣受惠於產業重回上升週期的紅利。市場預期景碩的 2027 年每股盈餘(EPS)有望成長至 12.68 元 。儘管過去其毛利率表現曾領先群雄,但在目前的 AI 擴散時代,產業競爭核心已轉向高層數與超大尺寸技術,景碩正透過持續的擴產計畫來維持競爭力。
整體而言,台廠載板三雄在經歷疫情後的庫存調整後,迎來 AI 基礎設施建設的黃金十年,且因台灣在全球先進封裝與 AI 供應鏈的中心地位,在 ABF 市場表現預計將優於日本同業 。
ABF 產業現況
前面段落也有提到,ABF 載板產業在歷經 Covid-19 疫情後的兩年下行週期後,已於 2024 年上半年觸底,並呈現向上轉折。過往使用較多 ABF 的個人電腦等中低階市場的復甦較為溫和,而高效能伺服器與 AI 相關終端需求的成長動能則更為強勁。雖然相關企業的股價已開始變動,但根據摩根士丹利(Morgan Stanley)在 26 年 2 月初具的報告,從基本面來看產業仍處於此輪 AI 驅動上升週期的早期階段,認為企業獲利才剛開始呈現向上趨勢。
原料供應與成本轉嫁的定價壓力
當前產業面臨的一個重要限制在於低熱膨脹係數玻璃纖維布(T-glass)的供不應求。2025-2026 的台灣供應鏈就是一個字「缺」。研究指出今年 T-glass 的供需缺口約為 20%,這種失衡在去(2025)年便開始顯現。雖然供應限制主要影響 BT 載板及中低階產品,對高階 ABF 載板廠商的直接影響相對有限,但還是推升整體供應鏈的緊張感。此外,隨著銅價上漲及覆銅板(CCL)廠商宣佈漲價,載板製造商也逐步將增加的原料成本轉嫁給終端客戶,帶動整體平均售價(ASP)回升,部分廠商預計在 2026 年上半年每季調漲價格 。
ABF 未來展望?
需求結構的深度轉型與 AI 核心驅動
展望未來五年,ABF 載板市場將經歷結構性的需求轉型。在 2015 年時,PC 市場佔總需求的 70%,但預計到 2030 年將降至 15% 左右;相對地,AI GPU、ASIC、伺服器及網絡通訊等相關應用,將在 2030 年佔據市場約 75% 的價值份額。這種由企業端驅動的需求與過往消費者驅動的 PC 週期不同,相較具備更高的需求可見度與持續性,法人預計 2025 至 2030 年間市場價值的年複合增長率(CAGR)將加速至 16.1% 。
產能缺口與技術升級的獲利機遇
儘管全球主要載板廠商持續投入產能擴充,但受限於建設與認證所需的時間,預計從 2027 年起市場將再度陷入供不應求的局面 。隨著晶片設計趨向大型化與多層化,例如: 2.5D 與 3D 封裝技術的普及,單一載板層數從傳統 PC CPU 的 8 層激增至 20 層以上,這將顯著降低生產良率並消耗更多實際產能。
同時,為了克服散熱與電磁干擾,埋入式被動元件載板與玻璃核心載板(Glass Core Substrate)等新興技術也成為研發重點,這些新技術雖然增加製造複雜度與維修成本,卻也為技術領先的廠商創造了更高的產業門檻與利潤空間,期待此產業的再一次升級!
【延伸閱讀】
- 第三代半導體是什麼?一文了解氮化鎵(GaN)、碳化矽(SiC)!
- 半導體產業:IC設計、IC製造、IC封測,一文了解產業鍊!
- 權值股是什麼?權值股有哪些?台積電漲一元大盤漲幾元?
- CCL(銅箔基板)是什麼?CCL 概念股有哪些?CCL 受惠 AI 伺服器?


