日月光過去的競爭對手多半為傳統的封測廠商,但近年台積電持續發展封裝技術,對日月光是否產生極大威脅?
本篇重點:
- 公司簡介—全球封測龍頭
- 日月光主要封裝技術—Wire Bond/Bump/FC/WLP/ SiP
- 先進封裝遭遇晶圓代工廠壓力靠天線模組突圍
- 成長機會—5G趨勢帶動 SiP 封裝需求/物聯網與車用電子趨勢帶動打線封裝
- 潛在風險—5G手機滲透率提升不如預期、上游晶圓代工廠產能不足
- 小結—封測產業仍有成長空間,日月光依然穩固
公司簡介—全球封測龍頭
日月光投控成立於 2018 年 4 月,是日月光半導體(2311.TT)於 2015 年發動對矽品精密(2325.TT)的併購戰後所成立的公司,因受到矽品原經營高層反對且有壟斷爭議,日月光半導體後來決定成立新的投資控股公司,即日月光投控,100% 持有日月光與矽品,且各自仍為獨立公司,併購前日月光與矽品,分別為全球第一大與第三大的封測公司,併購有助業內降低價格競爭壓力,並使日月光的全球封測龍頭地位更為穩固。
日月光投控的前身日月光半導體成立於 1984 年 3 月,隨半導體供應鏈從美國移轉至東亞的大趨勢與台灣半導體代工製造逐步成為全球第一的製造中心,並透過併購(包含 NEC、摩托羅拉等知名公司的封測工廠)與自行擴建,2003 年日月光首度超越原本全球封測龍頭,即 1968 年於美國成立的艾克爾(Amkor),並維持全球封測龍頭地位至今。

日月光投控提供半導體晶片的封測(封裝與測試)與電子代工(EMS, Electronic Manufacturing Services)服務。封裝的功能是將晶片以塑膠、陶瓷等材質包覆,以隔絕水氣、灰塵、靜電等對晶片的影響;測試則是挑出可用的晶片,通常封裝前與封裝後都會測試,完成封裝測試的晶片才可以出貨給下游的 EMS 廠,組裝成各式 3C 產品;電子代工服務最知名代表就是鴻海集團,為 3C 產品製造環節中最下游的組裝工作。


日月光主要封裝技術—Wire Bond(成本低可容納接腳少)/Bump(比打線封裝厚度低)/FC(可容納接腳較多)/WLP(覆晶封裝進階版須從面板廠等籍設備提升到晶圓代工廠)/ SiP (整合多個IC封裝減少 PCB 用量)
所謂封裝技術是指從台積電、聯電等晶圓代工廠出貨的晶圓,到封裝廠切割成 Die (也就是還沒封裝的晶片),要用何種方式連接到印刷電路板( PCB ), Die 上有很多 I/O (也就是接腳),由於 I/O 在 Die 上面的密度很高需透過封裝把接腳展開,拉大間距才可接上 PCB 。至於保護晶片的封裝外殼如前段所述,用塑膠、陶瓷等材料包覆,不同技術差異不大。
封裝與測試後的晶片會送到鴻海、廣達、華碩、微星等組裝廠與其它晶片或電子元件透過 PCB 連接,可做成一般市售的主機板、顯示卡等,甚或再加入機殼、風扇、電源等直接做成完整的 3C 產品,如手機、筆電等。
打線封裝(Wire Bond)
打線封裝屬於較早期低階的封裝技術,晶片正面是有 I/O 的一面, I/O 透過第一次銲接與一般為銅或金的線材連接,線材從 Die 的外圍繞到 Die 的背面,並拉大金屬線間距,在 Die 的背面與導線架載板進行第二次焊接(即圖三中導線載板由三井高科技、長華科技等公司提供),最終透過導線架的金屬接腳與 PCB 連接。

打線封裝的線材早期因金的延展性好,良率高,為主流材料,不過近年已逐漸克服銅延展性不佳的問題,銅材料已成為打線封裝主流。打線封裝適用於 I/O 較少的晶片,而成本最低,以晶片數量來看,目前多數晶片仍採用此封裝技術。
金屬凸塊(Bump)與覆晶封裝(FC,Flip Chip)
金屬凸塊與覆晶一般兩者技術會一起使用,覆晶封裝是指將原本 Die 的正面倒過來,透過金屬凸塊(Bump)直接與導線載板連接再連到 PCB 板上,採用這種技術封裝完的晶片,體積與厚度會遠小於原本的打線技術。
覆晶封裝難度比原本打線高,主因有二。一、為了減少體積與厚度必須捨棄原本打線封裝的線材,改為直接從 Die 上的 I/O 點位長出細小的金屬凸塊,需要用到黃光與蝕刻再配合電鍍等製程,黃光與蝕刻等已類似晶圓代工廠的製程,而採用設備為面板廠等級,為早期封裝測廠不具備的能力。二、導線架載板需改為覆晶載板(即圖四中的導線載板),覆晶載板面對 Die 那面的金屬接腳密度相當高,等同於 Die 上 I/O 的密度,傳統導線架載板廠商無法供應這類型載板,目前一般是封測廠自行製造或 PCB 板廠商提供,打線封裝是透過連接 Die 的線材,拉大金屬線間距,而覆晶封裝則是透過覆晶載板內部的電路布線去拉大金屬線間距,再由覆晶載板的另一面透過金屬接腳與 PCB 板連接。
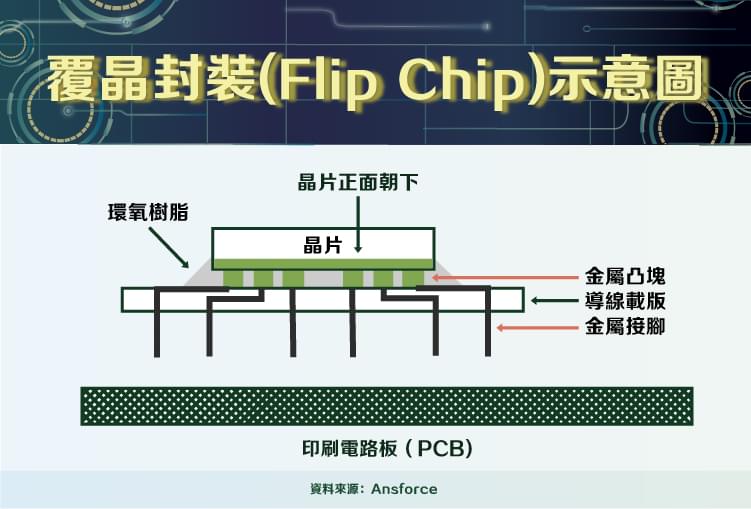
晶圓級封裝(WLP,Wafer level package)
捨棄傳統上先將晶圓切割成 Die 再封裝,改成先在晶圓上完成大部分封裝製程後再進行切割,晶圓級封裝可視為覆晶封裝的再進階,金屬凸塊會更細小,覆晶載板的布線密度會更高,一般名稱會改為中介層,此時就非面板廠等級的設備可以做到,必需改用晶圓代工廠等級的設備。
系統級封裝( SiP ,System in a Package)
系統級封裝則是在一個 ” 整合 ” 晶片中,封裝一種或多種晶片或記憶體,也封裝進被動元件、射頻元件或天線等某一項或多項元件(要整合多少沒有規範),減少 PCB 布線與用量,並讓整體體積縮小是其主要優勢。
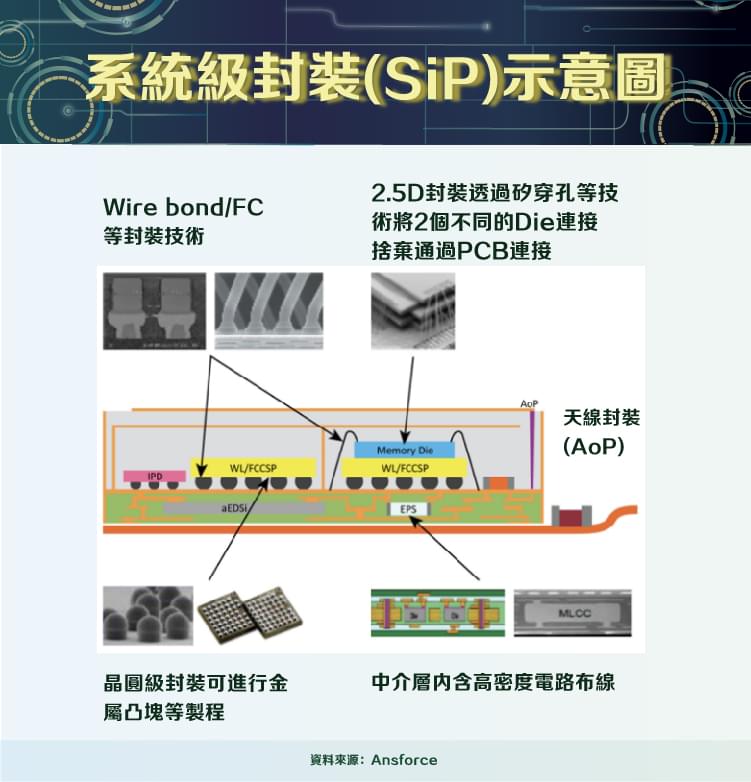
一般除了打線封裝以外的封裝技術,業界都統稱為先進封裝
先進封裝遭遇晶圓代工廠壓力靠天線模組突圍
從前述封裝技術介紹可發現,先進封裝越走似乎就越需要晶圓代工廠的技術實力,在需要非常低功耗的晶片上,像是 iPhone 的處理器,因晶圓代工廠有能力把處理器 Die 對外連接的金屬材料做到最細(降低功耗的重要因素),封測廠確實難以匹敵,不過在 Si封裝上,因晶圓代工廠多數沒有自行生產 DRAM,也沒有生產被動元件或天線等, SiP 也不一定要用到像晶圓代工廠這麼高階的設備,封測廠仍可掌握一片天。
像日月光就靠 SiP 技術整合天線、射頻元件甚至是基頻晶片而掌握了 iPhone 、Apple Watch、AirPods 的天線模組封裝訂單。
小結—封測產業仍有成長空間,日月光依然穩固
車用半導體中除了自駕晶片以外,大部分都不需要用先進的封裝技術,傳統的打線封裝即可,物聯網所需的晶片大部分也是,近期傳出多國政府向台積電要車用晶片產能的新聞,顯示需求相當強勁,傳統打線封裝需求強勁,日月光近期也調漲打線封裝價格,但如果上游缺貨狀況遲遲未解決,需求並沒有轉化成營收,也可能有表現低於預期的風險。
同時 iPhone 進入 5G 時代開始採用日月光的 SiP 技術(日月光稱為 AiP 就是天線用的 SiP ),其它手機廠也有機會跟進對日月光有利。
整體而言,日月光在最先進的封裝技術面臨台積電大廠的競爭,但未來趨勢包括車用、物聯網等對於低階封裝技術的需求也相當強勁,封測產業預期仍可持續成長,另外,日月光 SiP 技術持續被大廠青睞,相信其在封測產業的地位仍然穩固。
參考資料:
- 日月光
- 芯思想研究院
- Ansforce
- Digitimes
- 鉅亨網
【延伸閱讀】


