近期市場媒體最熱門的話題不外乎就是「AI」帶來的大熱潮了,AI 可以說是今年股市的「救世主」,從一開始最直接相關的 Nvidia 一路飆漲,市場也開始尋找與 AI 相關的供應鏈及潛力股。從 6 月最新的台積電( 2330-TW )股東會中,可以發現董事長劉德音先生一再提到「先進封裝」這項技術與 AI 的相關性,究竟先進封裝這項技術跟傳統封測廠之間有甚麼差異?以下就讓我們先帶大家了解 IC 封測這項歷史悠久的製程技術。
編按:(2026 年 2 月 10 日)艾克爾(Amkor)明確定調 AI 與 HPC 為 2026 年成長雙引擎
全球第二大專業封測廠艾克爾(Amkor, AMKR)在 2026 年 2 月最新法說會中,由新任執行長 Kevin Engel 首度主持並釋出明確展望,指出 AI 與高效能運算(HPC)將成為公司未來數年的核心成長動能。管理層預估,2026 年「運算相關業務」營收年增幅度可望超過 20%,並同步擴充 2.5D 與高密度扇出型封裝(HDFO)產能,預計今年相關產能將接近三倍成長,以回應 AI 資料中心實際訂單需求。對應此一趨勢,艾克爾規劃 2026 年資本支出達 25 至 30 億美元,重點投入美國亞利桑那州新廠與先進封裝、測試產能。先進封裝需求已從技術驗證階段,進入資本支出與量產擴張期,全球封測廠正同步受惠於 AI 與 HPC 長線趨勢。
編按:(2026 年 2 月 9 日)IC 設計、製造、封測三箭齊發,台股由半導體供應鏈領軍大漲
2026 年 2 月 9 日,台股在國際股市同步走強下大幅上漲,盤中一度勁揚逾 880 點,指數站上 32,600 點以上,盤面結構呈現明確的「IC 產業鏈全面發動」。IC 設計端由聯發科領軍,盤中重返 1,800 元關卡;IC 製造核心台積電跳空大漲直逼前高;IC 封測龍頭日月光投控則一舉創下 328 元歷史新高。封測族群同步轉強,包含京元電、欣銓、中華精測、力成等皆有明顯漲幅,顯示市場資金並非單點題材操作,而是重新評價整體半導體供應鏈在 AI 與 HPC 景氣回升下的結構性機會。
編按:(2026 年 2 月 8 日)力成不再只是記憶體封測,FOPLP 正式切入先進封裝主戰場
IC 封測廠力成科技宣布其長期投入的扇出型面板級封裝(FOPLP)技術正式開花結果,並獲得博通(Broadcom)、超微(AMD)兩大晶片巨頭實質支持。相關設備供應商亦為其打造客製化產線,顯示力成在先進封裝領域的布局已獲產業鏈高度認可。力成董事長指出,目前無論是先進製程或先進封裝皆呈現供不應求態勢,公司定位為「非台積電陣營的重要替代選項」。隨著 FOPLP 業務推進,力成規劃 2026、2027 年資本支出皆接近 400 億元,相關營收貢獻預期於 2027 年後逐步顯現。此一轉型,也正式打破市場對力成僅為記憶體封測廠的既有印象。
編按:(2026 年 1 月 21 日)中國長電完成 CPO 矽光子引擎送樣,搶攻次世代算力封裝
中國封測大廠長電科技(JCET Group)宣布,其基於 XDFOI 多維異質先進封裝平台所打造的 CPO(光電共封裝)矽光子引擎,已完成客戶送樣並成功通過測試。在 AI 模型規模與 HPC 傳輸需求快速擴張下,傳統電訊號互連逐漸逼近物理極限,CPO 被視為解決高頻寬、低延遲與能源效率瓶頸的關鍵技術。長電透過在封裝層級實現光電元件與邏輯晶片的高密度整合,成功縮短互連距離、降低系統損耗,並提升整體延展性。
日月光投控(3711-TW)公布 2025 年 6 月自結合併營收為 495.13 億元,月增1%,年增 5.51%;第二季營收1507.5億元,季增1.8%,年增7.5%;累計今年上半年營收2989.03億元,年增9.47%。儘管匯率不確性增加,但 AI 和高效能運算 (HPC) 晶片先進封測需求仍穩健成長,日月光投控第二季營收仍微幅向上,月營收和季營收皆創同期次高。
力成(6239-TW)公布 2025 年 6 月合併營收為新台幣 62.63 億元,月增 3.03%,但年減 4.09%。累計上半年營收為 335.53 億元,年減 11.5%。觀察力成今年月度營收趨勢,自 2 月以來連五個月回升。執行長謝永達指出,在 AI 應用推動下,DRAM 與 NAND 封測需求增溫,SSD、PC換機潮亦帶動成長動能,隱隱有擺脫首季頹勢,預期第2季將明顯回升、第3季續強。
封測是什麼?
在股感知識庫中我們有介紹過整個半導體產業鏈發展,從原先的 IDM(垂直整合製造)模式逐漸發展成現今的 IC 產業鏈專業分工模式,其中就分為 IC 設計、IC 製造、以及 IC 封測三段不同的製程階段。其中 IC 封測就是整個半導體製造過程中最後的階段,主要目的確保 IC 成品的良率,對其進行測試、包裝保護。

▲IC 封測是整個 IC 製造鏈的下游部分;圖片來源:產業價值鏈知識平台
封裝是什麼?
我們所熟知的台積電製造出 IC 其實一開始並不是我們所想像的方形塊狀,而是由矽晶圓(Wafer)經過曝光、顯影、氧化、蝕刻等過程印上電路圖後佈滿一塊塊的裸晶。這時候的 IC 其實是非常脆弱的,因此需要「封裝」這個步驟將其變得更加耐用。封裝就是將其包覆起來,並且在上面接上可以與 PCB 版導通的材料(不然就不能用了),最後就變成我們肉眼可見的電路模樣。因此 IC 封裝主要可以分成兩個部分:IC 與 IC 載板間的連接、IC 載板與 PCB 板之間的連結。
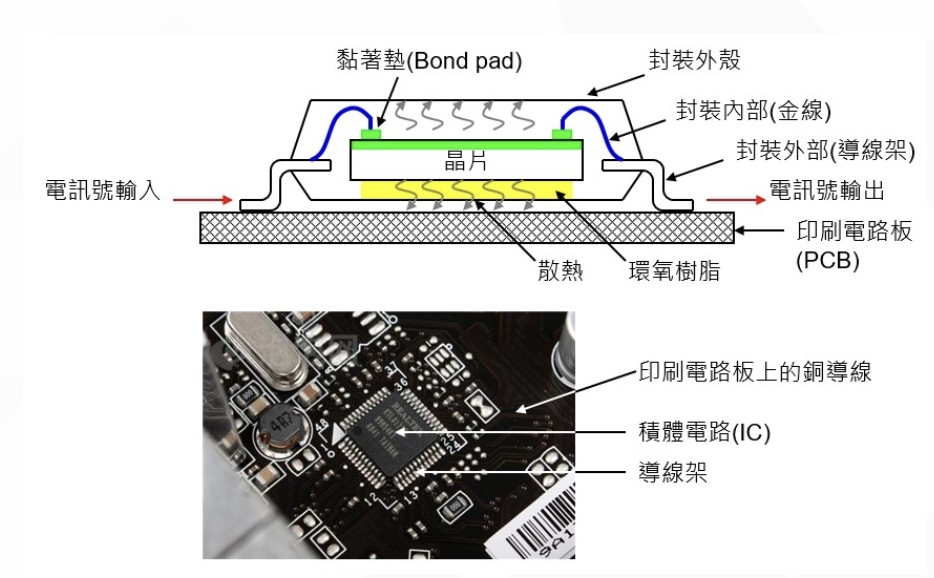
▲傳統的打線封裝示意圖;圖片來源:經濟部技術處
測試是什麼?
當我們將原本「裸露的晶片」穿好衣服、接好裝備後,接著我們就要測試其可用性了。我們都知道任何的電子產品製造廠都有所謂「良率」差異的問題,也因此測試這項過程其實與封裝是交互進行的。根據晶圓廠製造出來的 IC 應用,許多時候會在 IC 封裝前就先進行測試,透過探針卡來將不良的晶片先排除掉。最後在封裝完成後也會再次進行測試的步驟,以完成品質控管。
封測流程
目前的 IC 封測技術可以說是非常多元,由於晶片愈來愈微縮,也因此衍生出各式新興的封測技術,以下我們先以最簡單的方式將 IC 封測流程簡化為三大步驟,詳細的技術內容則仍有細節上的差異。
- 封裝前測試:在將 IC 晶片封裝到外殼之前,需要對晶片進行電性測試,以篩選出不合格的晶片,並記錄晶片的位置和編號。這個步驟可以提高封裝的效率和良率,並降低成本和廢料。目前主要是透過探針卡(Probe card)針對晶粒做電性測試,藉由輸出訊號來判斷有哪些晶粒有故障的狀況。光「探針卡」這項東西就有許多不同的專利類別,規格上根據終端產品的不同有許多差異,台灣有數間上市櫃公司就是專門在研發與製造這項技術產品。
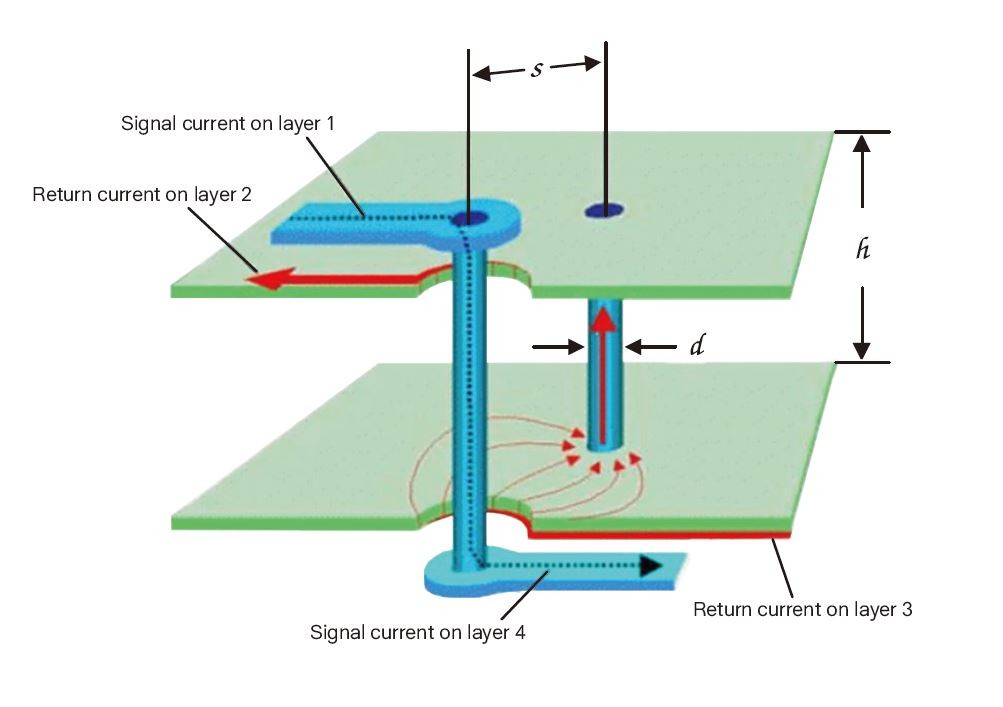
▲圖片來源:中華精測
- 封裝過程:將 IC 晶片封裝到外殼中,傳統上有兩種方式,透過銲接方式或是粘合方式。銲接方式是將晶片的引腳與外殼的引腳用金屬焊料連接起來,粘合方式是將晶片用膠水或其他材料固定在外殼上,然後用金屬線或其他方式連接晶片的引腳和外殼的引腳。以上所使用的封裝模式都是應用在較不需要先進邏輯技術的電子產品,隨著晶片愈來愈微縮,IC 封裝針對散熱、耐用的要求性也愈高,也因此進入到先進封裝的年代。封裝技術從原本的封裝元件概念轉為「系統級封裝(SiP)」,將多功能的晶片(記憶體、CPU 等)整合在一起,發展出 2.5D 、 3D 等堆疊技術。這些技術的成本較高,也因此主要是應用在高端產品中。其中除了傳統的封測廠有所著墨外,台積電自己就掌握了最先進的封裝技術。
- 封裝後測試:在封裝完成後,需要對 IC 進行功能測試和環境測試,以檢查 IC 是否符合法格要求,以及是否能夠承受各種環境條件。功能測試是對 IC 的電性、邏輯、頻率等方面進行測試,環境測試是對 IC 的溫度、濕度、震動、衝擊等方面進行測試。這個步驟可以確保 IC 的性能和穩定性,以及適應不同的應用場合。
封測概念股
封測廠排名
台灣是在整個 IC 產業鏈分工模式當中最具舉足輕重地位的國家,因此全球最大的專業 IC 封測廠其實就在台灣。根據工研院資料顯示, 2024 年全球 IC 封測廠營收排名前十名中就有近一半是台灣的企業,包括日月光投控( 3711-TW )、力成( 6239-TW )、京元電子( 2449-TW )等。
| 2024 年全球前十大封測廠營收排名 | |||
| 排名 | 公司名稱 | 2024 年營收(億美元) | 2024 年市占率 |
| 1 | 日月光 | 185.4 | 44.6% |
| 2 | 艾克爾科技 | 63.2 | 15.2% |
| 3 | 長電科技 | 50.0 | 12.0% |
| 4 | 通富微電 | 33.2 | 8% |
| 5 | 力成科技 | 22.8 | 5.5% |
| 6 | 天水華天科技 | 20.1 | 4.8% |
| 7 | 智路封測 | 15.6 | 3.7% |
| 8 | 韓亞微 | 9.2 | 2.2% |
| 9 | 京元電子 | 9.1 | 2.2% |
| 10 | 南茂 | 7.1 | 1.7% |
資料來源:工商時報、TrendForce
不要看到 IC 封測產業分類就以為他們都是做一樣的東西歐!像日月光(矽品也隸屬於日月光投控集團下)、京元電其實是專注於像手機、通訊、穿戴式裝置等消費性電子產品的 IC 封裝測試,同時也有伺服器、CIS 裝置等相關產品,客戶包含台積電、聯電( 2303-TW )等 IC 製造大廠;力成則是記憶體相關的 IC 封測,客戶橫跨金士頓、美光等;南茂及頎邦則是專注於面板驅動 IC 相關的封測,同時也有橫跨記憶體模組相關產品。
封測概念股「漲」聲響起!?
近期各大半導體業公布 6 月營收,可以發現大多封測廠都開出了營收成長好成績,包含日月光、京元電等。但是,儘管 AI 市場需求逐步回升,維持一定的成長動能,但受地緣政治風險和總體經濟變數影響,業者對未來發展仍持保守看法,尤其是關稅政策變動與新台幣匯率波動的不確定性,讓國內半導體廠對 2025 下半年景氣的預測趨於謹慎。
若進一步觀察台灣封測產業的指標廠商 日月光投控 與 京元電,可以發現市場對封測族群的評價,已與過去明顯不同。
過去封測業因產業成熟、成長性有限,股性普遍偏向穩定,長期被市場視為高殖利率、防禦型標的,本益比區間也相對保守。然而,隨著 AI 與高效能運算(HPC)需求快速放大,封測在先進製程後段的重要性明顯提升,資金對產業的期待開始出現結構性轉變。以京元電為例,隨著承接 NVIDIA 等大客戶的 AI 與 HPC 晶片測試訂單,市場逐步反映其在高階測試領域的戰略地位。股價在過去一段時間呈現沿中期均線緩步上行、回檔即有支撐的型態,顯示投資人對其未來營收與接單能見度的預期,已不再僅以景氣循環視之。

相較之下,日月光投控的股價走勢則呈現高檔震盪整理,反映市場在重新評價其先進封裝成長潛力的同時,也仍在消化其業務結構較為多元、對終端景氣與關稅環境敏感度較高的現實。日月光持續與台積電在 WoS(如 CoWoS 外包)等先進封裝領域維持合作關係,相關業務動能具備中長期支撐,但整體評價仍需時間由基本面逐步驗證。

封測產業現況
隨著 AI 與高效能運算(HPC)需求持續擴大,全球 IC 封測產業已明顯走出 2023 年的修正循環,並在 2025 年進入較為健康的成長階段。產業資料顯示,AI 應用推升先進封裝與高階測試需求,相關產能利用率維持在高檔,訂單能見度也同步拉長。儘管部分傳統消費性電子市場仍在調整庫存,但自 2025 年第二季起,整體市況已逐步改善。在 AI、HPC 與傳統需求回溫的共同帶動下,市場預期 2025 年全球 IC 封測產值將達約 416.7 億美元,年成長約 6.6%,產業動能重回正向。
先進封裝與記憶體需求,推升封測稼動率
進入 2026 年後,半導體供應鏈的重心明顯往先進製程與先進封裝集中。AI 晶片與高頻寬記憶體(HBM)需求持續放量,上游晶圓代工與記憶體原廠的產能配置,進一步拉高下游封裝與測試端的負載。台灣多家封測廠的稼動率,自 2025 年下半年起快速回升,部分針對 DDR5、AI 與 HPC 相關規格的產線,已出現產能吃緊的情況。在產能利用率攀升、電力與人事成本同步上揚的背景下,市場開始關注封測報價調整的可能性。對客戶而言,在 AI 與 HPC 晶片供需緊張的環境中,交付穩定度的重要性明顯提高,也讓具備產能與技術優勢的封測廠,擁有更實質的議價空間。
封測角色升級,成為供應鏈關鍵環節
AI 與記憶體需求帶動的封測回溫,已超越單純的景氣循環。隨著晶片設計複雜度提高、測試時間拉長,封裝與測試在效能、良率與交付穩定度上的重要性持續提升。這也讓封測產業在半導體供應鏈中的定位逐步上移,成為支撐 AI 與 HPC 發展的重要一環。
封測未來展望
綜合近期多家封測廠的法說與產業動態可以發現,AI 與高效能運算(HPC)對封測產業的影響,已實際轉化為資本支出、產能擴張與技術路線的全面調整。從產業龍頭的表態來看,先進封裝需求已明確走向量產與長約支撐。無論是 2.5D、扇出型封裝,或是更高密度的異質整合方案,相關投資重心已同步移往美國與主要算力市場,顯示 AI 資料中心建設正在重新定義後段製程的重要性。封測廠在這一波週期中成為算力基礎建設中不可或缺的一環。
另一方面,先進封裝的快速放量,也正在重塑產業分工。隨著晶圓代工龍頭持續強化自有先進封裝能力,後段封測廠逐步朝向「非主流製程、ASIC 專用封裝、系統級整合」等差異化方向發展。從 FOPLP、HDFO,到 CPO 等新技術路線,封測廠正嘗試建立不完全依附單一製程陣營的競爭位置。
封測產業正處於一個由 AI 與 HPC 驅動的結構轉換期。短期仍需觀察終端客戶去化庫存與專案節奏的波動,但中長期來看,隨著算力需求持續擴張、封裝技術持續升級,具備技術門檻、客戶黏著度與資本投入能力的封測廠,將有機會在這一輪產業循環中,取得比過往更關鍵的位置。
【延伸閱讀】
- 半導體產業:IC 設計、IC 製造、IC 封測,一文了解產業鏈!
- 晶圓代工是什麼?圖解晶圓製造流程!
- 台積電( 2330 ) – 全球半導體霸主!營運概況、公司簡介
- 矽格做什麼的?股價?矽格最新財報數據!
- 南茂做什麼的?股價?南茂最新財報數據!
- 矽晶圓是什麼?矽晶圓三雄是誰?矽晶圓族群與產業介紹!


