摩爾定律引領半導體產業持續發展,不過當先進製程進入『一奈米』以下時,面臨技術上及成本上的瓶頸,未來晶片很難依靠『先進製造』持續提升效能,未來將會是『先進封裝』成為關鍵的突破口,達到 More than Moore (MTM,超越摩爾定律)。
目前 AI 產業成為全球最重要的議題,無論是 NVIDIA 或 AMD 的 AI 晶片,皆需要低延遲、高傳輸速動,目前能滿足這樣的需求,需要靠台積電的 CoWoS 先進封裝技術,CoWoS 先進封裝使用 2.5D / 3D 的晶片堆疊技術,將各種晶片整合封裝至基板上,讓晶片之間的線路間距縮小,擁有面積小、節省功耗、節省成本、提高晶片效能等優勢。除了 CoWoS 之外,台積電還有另一個 3D 先進封裝技術,名為『SoIC』(System-on-Integrated-Chips),目前 SoIC 技術還剛起步,未來的需求及應用不容小覷。
編按:2024/07/04 更新,台積電先進封裝再傳喜訊!根據摩根史丹利分析師指出,蘋果下世代的 AI 伺服器晶片和 M 系列晶片將採用台積電 SoIC 封裝技術,並搭配 2 奈米製程生產。
SoIC 封裝是什麼?
台積電的 SoIC(System-on-Integrated-Chips)是業界第一個高密度 3D 小晶片堆疊技術,應用於十奈米及以下的先進製程進行晶圓級的鍵合技術,透過 Chip on Wafer (CoW)封裝技術,將不同尺寸、功能、節點的晶粒進行異質整合,它就是一種晶圓對晶圓(Wafer-on-wafer)的接合,被視為進一步強化台積電先進奈米製程競爭力的關鍵。投資圈認為,從台積電提出的 2.5 版 CoWoS 技術,以及獨吃蘋果的武器 InFO 技術,下一個持續站穩晶圓代工龍頭的關鍵,就是 SoIC 技術。
那 SoIC 與 CoWoS 技術差異在哪?簡單來說,
- CoWoS 可以分成『CoW(Chip-on-Wafer)』、『WoS(Wafer-on-Substrate)』,從最上面的平台來看,把將 CPU、 GPU 、 HBM 、電源IC 等晶片,利用矽中介版(Interposer)與矽穿孔(TSV)水平整合成晶片(CoW),再把他封裝基版上面(WoS),達到減少晶片的空間,同時還減少功耗和成本,此技術困難在於『異直整合』。
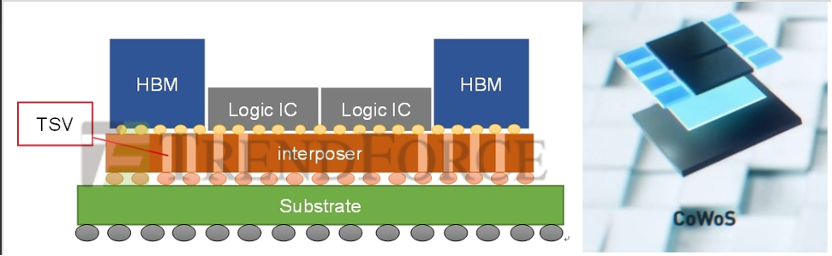 (資料來源:TrendForce、台積電)
(資料來源:TrendForce、台積電)
- SoIC 是業界第一個高密度 3D 小晶片堆疊技術,這種多晶片堆疊技術沒有突起的金屬凸塊接合結構,取而代之的是更短的訊號傳輸路徑,可將不同尺寸、功能、節點的晶粒進行異質整合。SoIC 本身為一個單晶片,關鍵技術在於透過矽穿孔(TSV)在晶片上以化學蝕刻或雷射的方式鑽孔,將多個晶片連結上下不同的晶片,把所有晶片垂直堆疊在一起,目前技術可以堆疊 12 顆晶片,未來技術若持續進步,可在同一個空間裡面堆疊更多的晶片,不過因為要在『晶片內直接製作矽穿孔(TSV)』,此項技術困難度極高,目前適合此項技術的晶片僅為高頻寬記憶體(HBM:High Bandwidth Memory),因爲存取記憶體的結構相對簡單,矽穿孔(TSV)技術也比較成熟,所以是最先成功製作出 3D 立體封裝的積體電路。
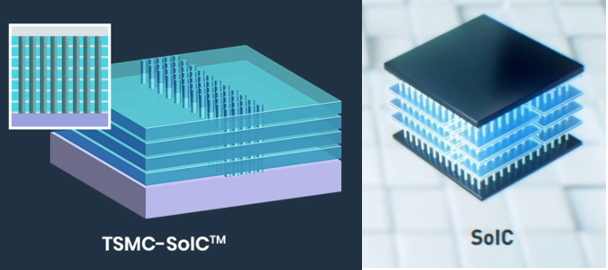
(資料來源:台積電)
綜合上述, CoWoS 封裝與 SoIC 封裝主要的差異在於,SoIC 封裝去除了矽中介版(Interposer),將不同功能的晶片以TSV(矽穿孔)的方式直接連接,降低封裝高度、縮短晶片間的傳輸路徑、提高晶片運算速度。
| CoWoS SoIC 差異 | ||
| 封裝技術 | CoWoS | SoIC |
| 全名 | Chip-on-Wafer-on-Substrate | System-on-Integrated-Chips |
| 封裝維度 | 2.5D | 3D |
| 使用矽中介板 | 有 | 無 |
| 矽穿孔 | 有,透過過矽中介板和矽穿孔整合晶片 | 有,不透過矽中介版,直接將晶片與晶片垂直方式堆疊 |
| 目前應用狀況 | 已經商用化,開始出貨 | 目前還在試單,及研發討論中 |
SoIC 與 CoWoS 為合作關係,並非替代關係
台積電將先進封裝技術分為『前端封裝』跟『後端封裝』,
- 前端封裝 :使用 SoIC 技術,在晶圓上將同質或異質小晶片垂直整合到一個類似 SoC (System on a Chip)的晶片中,在外觀上,新的晶片就跟普通的 SoC 類似,但包含了多種晶片的功能。這種前端封裝技術,由於是將不同功能的晶片整合成一個晶片,故在設計階段時,需要與客戶共同設計。
- 後端封裝:完成前端封裝完成 SoIC 晶片,再搭配原有的立體封裝技術,像是前面提到的 CoWoS 封裝技術的oS (on Substrate),將SoIC 晶片封裝在基板上(Substrate)。
透過下圖,可以更清楚了解,在現有的 CoWoS 先進封裝上,SoIC 晶片替代原 SoC 晶片,讓在一樣空間大小內,提升晶片的傳輸速度更快、功耗更低、降低成本 。
 (資料來源:台積電)
(資料來源:台積電)
SoIC 封裝目前的應用
SoIC 技術適用於運算速度快速的高效能產品,但此項技術難度也較高,因為晶片與晶片或是晶圓與晶圓需要完全接合,所以兩個晶片或晶圓的表面都需要平整,需要提升堆疊晶片的可靠度與良率。截至 2024 年 4 月, AMD 是台積電 SoIC 先進封裝首發客戶,最新的 MI300 晶片就是 SoIC 搭配 CoWoS ,目前在竹南的第五座封測廠 AP6 生產。此外,依據外媒報導, APPLE 、 Broadcom 、NVIDIA 也對 SoIC 先進封裝感興趣,目前蘋果將採 取 SoIC 搭配 Hybrid molding (熱塑碳纖板複合成型技術),目前正小量試產,預計2025 ~2026年量產,預計應用於 MAC,博通、輝達也正在嘗試新的SoIC封裝方案。
SoIC 會成為未來趨勢嗎?
目前來說,台積電先進封裝最大的大客戶 NVIDIA ,雖然目前仍是青睞 CoWoS 封裝技術,但是 AMD 、 APPLE 、 Broadcom 、 NVIDIA 等美國大廠為了不斷提升自身晶片需求,也陸續與台積電合作 SoIC 先進封裝的方案。現在 SoIC 技術才剛起步,且技術還沒落地投產商用化,不過,看到 CoWoS 在 2023 年之前也是無人問津,早在 2012 年時 CoWoS 技術就已經被研發出來,但由於那時技術不夠成熟且客戶覺得價格過於昂貴,所以暫時不被投資界重視,現今在 AI 快速發展之下,晶片高速運算的需求日益提升及先進製程遇到瓶頸之下,垂直堆疊的先進封裝必然會是下一個關鍵技術,台積電目前除了持續擴增 CoWoS 封裝產能,也持續推動下一代 SoIC 封裝,目前 SoIC 晶片將進行小規模試產,預計最早 2025-2026 年正式量產,根據外媒 WCCFtech 的說法,由於這項技術降低積體電路板的價格,對於用戶端推估可節省大量成本。
SoIC 概念股
綜合上述,台積電的 SoIC 仍在試產,且與美國 HPC 大廠的合作也仍在初期階段,目前還沒正式落地投產且商用化,因此還沒有明確的概念股出現,但仍可以從現有的 CoWoS 概念股尋找。
| SoIC 概念股-台積電先進封裝供應鏈 | |||||
| 濕製程設備 | AOI 設備 | ||||
| 弘塑(3131) | 辛耘(3583) | 萬潤(6187) | 均豪(5443) | 均華(6640) | 志聖(2467) |
上述提及的個股,在近期法說會及公開資訊中,有提到除了 CoWoS 先進封裝設備之外,也提及未來將繼續朝向 3D 封裝,皆可留意後續產業技術的發展,及相關供應鏈的變化。
結論
目前先進封裝技術仍是 CoWoS 為主,不過目前股價來說,相關概念股在2023年5月已經先針對題材面飆漲一段,然而相關設備廠營收旺季在 2024 年上半年,故股價也在上半年開始反映營收成長。展望2024年下半年到2025年上半年, SoIC 的題材是否會開始發酵,值得期待。
股價總是在資訊曖昧不明的時候開始飆漲,再來股價會提前反應營收成長,最後真正確定營收成長時,漲勢走向落幕,如何在抓住起漲點並先行佈局,就需要抓住未來產業是否有爆發的潛在成長, SoIC 技術值得投資朋友長線追蹤。
【延伸閱讀】

