因為缺晶、台積電和地緣政治等多種因素的影響,大家對半導體產業的關注度火速提升。這也讓 ASML 這些原本在背後默默支持半導體產業發展的企業被 “ 趕 ” 到了台前。作為全球領先的半導體設備供應商,這家來自荷蘭的企業提供了全球晶片生產都繞不開的關鍵設備——曝光機。
尤其是在 EUV 曝光機方面,市場的關注度更是空前。這一方面是因為這個設備是晶片製造工藝走向 7nm 以下的關鍵;另一方面,這個設備的售價高達上億美金,且只有 ASML 一家能做。因此其吸引了全球那麼多的目光也情有可原。正如很多分析人士所說,EUV 曝光機可以稱得上是晶片製造的 “ 皇冠 ”。
以 EUV 曝光機為例, ASML 技術開發副總裁 Tony Yen 在今年三月接受媒體採訪的時候曾經表示, EUV 曝光機由超過 10 萬個精密零組件組成;相關報導也指出, EUV 曝光機重量達 180 噸,體積十分龐大,需要 0.125 萬千瓦的電力,來維持 250 瓦的功率;紐約時報在之前一篇介紹 ASML 的文章中更是強調, EUV 曝光機的運送需要使用 40 個貨櫃、 20 輛卡車和三架波音 747 飛機。
這樣一個龐然大物,不但需要在晶圓上做一些精度極高的工作,而且還需要保持更高的產能,從其零件構成上看,正如其名字 “ 曝光機 ” 所定義的一樣,要明白這一切,就首先得從曝光機的工作原理談起。
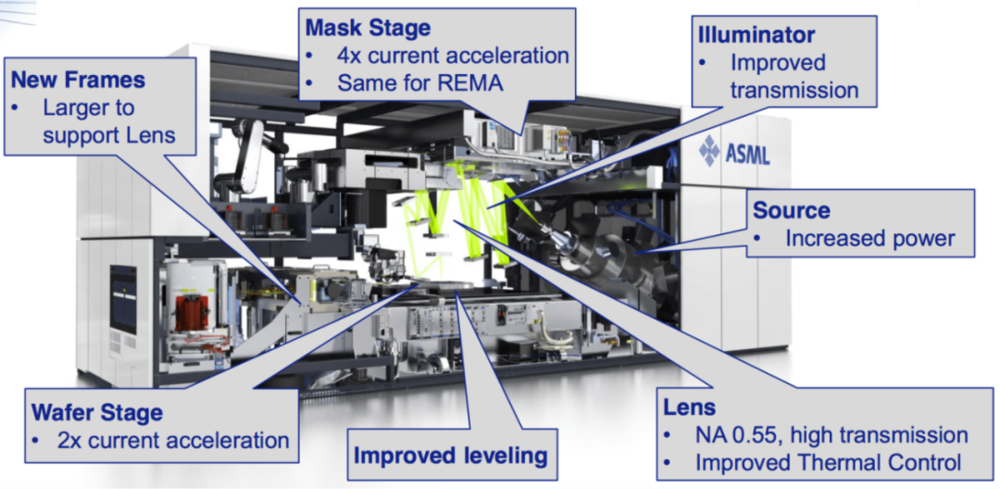
▲EUV 曝光機的內部工作原理(來源: ASML )
從一條公式談起
正如 ASML 所說,曝光的本質其實是一個投影系統。光線被投射通過掩模版,成像在晶圓上,最終在晶圓上一層一層建立起複雜的晶體管。在曝光技術不斷朝著 “ 更小 ” 邁進。
在曝光領域,有一個公式和 “ 摩爾定律 ” 一樣引導著產業的發展。而與摩爾定律不同的是,這一物理公式所揭示出的光學原理似乎更加難以逾越。那就是幾乎懸掛在 ASML 每個辦公室的瑞利判據(Rayleigh criterion)公式。

▲瑞利判據公式(source: ASML )
如上圖所示,在瑞利公式中, K1 是一個常數,取決於與晶片製造工藝有關的許多因素。按照 ASML 的說法,其物理極限值是 0.25 。 λ 則代表曝光機使用光源的波長;NA 則是光學器件的數值孔徑,描述了它們能夠收集光的角度範圍; CD 代表線寬,即可實現的最小特徵尺寸,大家所談的幾奈米晶片,就是為了把這個 CD 值做得更小。
從公式可以看到,為了讓 CD 變得更小,除了將 K1 和 λ 變小以外,把 NA 變大也是降低 CD 的一個選擇。據筆者了解,目前 K1 的值已經接近極限。為此產業把降低 λ 和提高 NA 作為繼續延續摩爾定律的重要發揮效果方向。

▲EUV 產品路線圖
在 NA 方面,根據報導,現在 ASML 正在探尋從 0.33 往 0.55 推進。據 semiwiki 在今年三月的報導, ASML 的 High-NA 曝光機現在已經從書面走向現實,且已經走到了構建模組和框架階段。根據他們預測,預計首批 High-NA 設備 其中 EXE: 5000 系統可能與 EXE: 5200 系統一起研發,原因是 EXE: 5200 系統將於 2025/2026 年成為第一批 High-NA 生產系統。英特爾(Intel, INTC-US)早前也表示,公司將在 2025 年用上High-NA曝光機,由此可以看到 semiwiki 的報導是合理的。
來到 λ 方面,為了降低其數值,如下圖所示,曝光機的光源在過去多年的發展從包括g-line和i-line在內的高壓汞燈開始,歷經 KrF 和 ArF,並在最近幾年進入到了 EUV 時代。對於未來,有人甚至認為曝光機的光源有望從 13.5nm 波長的 EUV 進入到波長介乎 0.01nm 到 10nm 之間的X光。
值得一提的是,為了進一步降低 λ ,產業界在曝光機演進的過程中,還引入了浸潤式曝光系統,讓DUV在推進晶片微縮過程中發揮了更多的作用。由此也可以體現出工程師的力量。
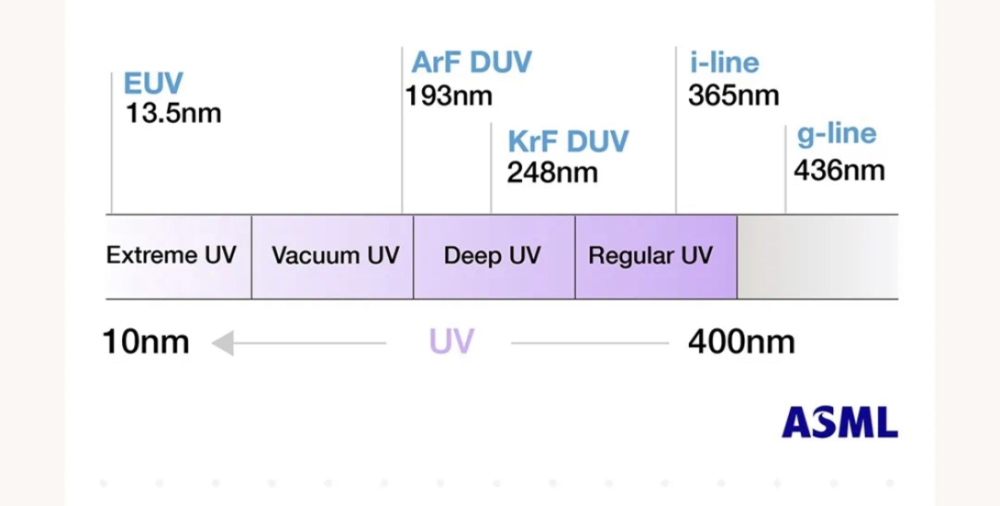
▲曝光機光源的演變(Source: ASML )
從上面的描述看來,要讓 CD 繼續縮小,唯有繼續降低 λ 這條路是最容易繼續走通的。但我們回看過去多年裡的光源發展歷程。這個看起來相對簡單的路,其實也不是一路坦途。尤其是在現在火遍全球的 EUV 曝光方面,真可以稱得上是供應鏈共同努力的結晶。
EUV 成為答案
日本知名分析師湯之上隆在 2007 年的時候曾以 “ EUV 的量產機是不是不能實現呢? ” 為題,對當時正在面臨開發困境的 EUV 進行相關調查。他提供的結果顯示,在問了 18 名曝光相關人員後,有 10 位給出的回答是 EUV 曝光機不能實現。誠然,對這麼一個擁有如此高度複雜性的設備來說, EUV 曝光無疑是一個極高難度的挑戰。尤其是在光源和鏡頭方面,帶來的挑戰更是前所未有。
從原理上看,曝光機的工作原理,就是讓光穿過光掩模,然後通過一系列透鏡將其縮小,最終落在覆蓋有曝光膠的基板上。由於光掩模,曝光膠的某些部分被光照射,使其變硬。在製造過程中,未曝光的部分在稱為蝕刻的過程中被化學洗掉。這樣做時,存在於抗蝕劑下方的材料也被去除。因此,在去除抗蝕劑的剩餘部分後,光掩模圖案就出現在矽片中(或在施加抗蝕劑之前已沉積在矽片上的材料中)“ 雕刻 ” 出來。
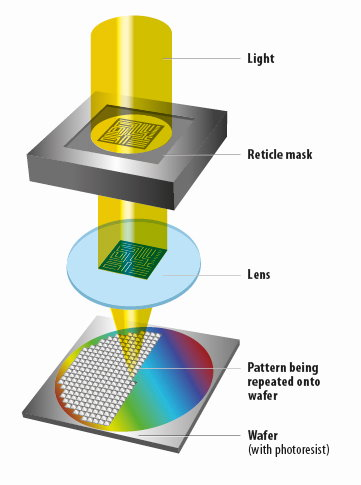
▲曝光機的基本原理
正如上文所說,為了實現更小的 “ 特徵 ” ,曝光機的光源歷經了幾代的演變,並最終進入到了 EUV 時代。但其實這並不是一帆風順的。據相關介紹,在後 DUV 時代,有三個潛在的候選者,分別是 EUV 、電子束和離子束曝光。
在發展幾年後,又多了 157 奈米的深紫外曝光選項。不過產業參與者最後發現, ASML 才是最終答案。因為為了獲得更高的解析度,你必須將離子和電子拉得更近,但這些粒子相互排斥。那就意味著您必須在提高解析度時降低電流。但這種設計帶來的反面後果是會阻礙頻寬。這在電子束和離子束上的。
但,問題也隨之而生。如下圖所示,在電磁波譜中,極紫外光是紫外區能量最高的部分。它的波長范圍為 100 奈米到 10 奈米,介於X 射線輻射(< 10 奈米)和深或遠紫外線(100 奈米到 200 奈米)之間。 更重要的是,地球上沒有 EUV 光源的天然來源。太陽的核心能產生 EUV 光譜,但沒有一個到達地球表面,因為大氣和臭氧層吸收了所有這些光。
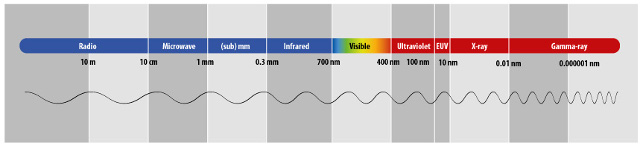
▲電磁波譜
綜上所述,這就使得其產生了兩個明顯的挑戰:
首先, EUV 光很難以受控方式產生。只有多重電離原子內殼中的激發電子才能發射 EUV 。你只會在熾熱、緻密的等離子體(例如太陽的最外層區域)中找到這些電子,而製造這些電子是一項相當艱鉅的工作。或者將自由電子通過同步加速器發射產生 EUV 光——這是一種巨大且極其昂貴的設備。
其次, EUV 光很容易被空氣和其他氣體吸收。這意味著光從產生的那一刻到撞擊矽片的那一刻,都必須穿過高質量的真空。這也意味著不可能構建 “ EUV 鏡頭 ” 。相反,需要使用高度複雜的曲面反射鏡。傳統的光掩模也會吸收過多的光,因此它也需要具有反射性。
換而言之,對 EUV 曝光機而言,光源和鏡頭部分會是最大的兩個挑戰所在。再加上其他系統,這勢必是一個浩瀚的設計工程,光靠 ASML 一家是完成不了。為此,荷蘭巨頭和業界多家廠商合作。如蔡司、Cymer 和通快,就是 ASML EUV 曝光機背後鮮被提及的巨頭。
鏡頭後面的 “ 大家 ”
如前所述,由於 EUV 光的特性,在 EUV 曝光機中,一個反射的鏡頭是非常重要的,也是非常複雜的,這主要因為現實世界中沒有任何材料可以在單層中反射大部分 EUV 光。然而多層則可以增強彼此的反射,於是業界探討用這種方式製作相當高效的 EUV 反射鏡來縮小和聚焦圖像。而由鉬(部分反射 EUV 光)和矽(對 EUV 大部分透明)交替奈米層製成的反射鏡就成為了大家努力的方向。
不過,這樣的 EUV 反射鏡的製作極其複雜,因為它們的表面需要幾乎完美光滑和乾淨,每個奈米層都需要具有精確定義的厚度。讓每個原子都需要在正確的位置,否則可能會丟失光或圖像可能會變形。蔡司毫無疑問又成為了大家求助的對象。
維基百科的資料顯示, 1846 年,時年 30 歲的卡爾・蔡司在耶拿建立了一個精密光學儀器加工廠,並於 1847 年生產出了他的第一台顯微鏡。 1866 年起,在恩斯特・阿貝和奧托・肖特的協助下,蔡司的工廠逐漸在顯微鏡領域有了較大的發展,並開始生產光學玻璃。 1888 年,蔡司開始涉足攝影業。同年,在恩斯特・阿貝的主持下蔡司基金會成立。 1891 年蔡司基金會成為蔡司工廠的唯一所有人。
回看過去一百多年的發展,蔡司始終都把光學相關器件當做公司的主攻方向,而半導體則是他們從二十世紀六十年代開始切入的賽道。自 1968 年第一次為為 AEG Telefunken 生產了第一個用於電路板打印機(當今晶圓步進機和掃描設備的前身)的鏡頭以來,公司在這個市場上一直穩紮穩打。
1977 年,蔡司推出了解析度為 1 微米的 S-Planar 10 / 0.28 透鏡,並將其用於美國公司 David Mann(後來的 GCA)製造的全球第一台晶圓步進機上;1982年,蔡司生產了第一個工作波長為 365 奈米(i 線)的光學系統 S-Planar 10/0.32 ,這是進入奈米世界的第一步(結構尺寸:800 奈米);1993年,蔡司推出的 S-Planar 5/0.6 透鏡(工作波長:365 奈米)是半導體市場的重大突破;1998 年推出的 Starlith 900 則是世界上第一個批量生產的 193 奈米波長曝光光學器件,這是第一個可以實現 100 奈米以下分辨率的系統;2007 年推出的 Starlith 1900i 是第一款達到 38 奈米極限分辨率的浸沒式光學器件,現在,全世界很大一部分高性能微晶片都是使用這種技術生產的;2012年,全球第一套 EUV 光學系統量產,蔡司又幫助半導體產業進入了一個新階段。
全球第一套 EUV 光學系統
據蔡司集團發布的截止到 2020 年 9 月 30 日的 2019 / 2020 財年的年報,公司半導體製造技術部門在統計週期內產生了 18.33 億歐元的收入,與上期相比(16.34億歐元)增加了12%。半導體製造技術部門的所有戰略業務部門都為這一新的收入記錄做出了貢獻,每一個部門的收入都比上一年有所增加。其中客戶對深紫外(DUV)和 EUV 曝光系統的高需求也在繼續。DUV 曝光系統則是該領域的主要收入驅動因素。
值得一提的是, ASML 在 2016 年宣布以約 11 億美元的現金收購了蔡司負責相關光學系統子公司 24.9% 的股份,同時還為聯合( 4129-TW )研發項目一次性出資約 2.44 億美元,並在未來六年(從2016年算起)內再花費 6 億美元用於資本設備和其他需求。由此可以看到蔡司在 EUV 曝光機中的重要性。
光源領域的強者
在上文的介紹中我們談到, EUV 的光源是無法自然產生的,且其擁有各式各樣的特性。為此如何產生光源,就成為橫亙在開發者面前的又一個難題。在 21 世紀初,Xtreme Technologies等企業所推動的,基於放電等離子體的光源似乎是最有希望的。但不久之後,激光生產的等離子體光源(LPP:laser-produced plasma)嶄露頭角,並最終成為日本、歐洲和美國的團體都在努力的方向。
從原理上看,這種方法是使用一個非常高功率(超過 30kW 平均脈衝功率的激光數,其脈衝峰值功率可高達幾兆瓦)的激光脈衝,打在不斷滴下的錫珠,然後轉化成為一個發光的等離子體,發射出波長為 13.5 nm 的 EUV 光。這些光通過聚焦後,通過反射透鏡首先傳輸到曝光掩模上,然後照射到晶圓基晶片。
上述的每一個步驟,都需要非常複雜的技術。例如在光源部分,就需要具體聚焦在激光脈衝是如何產生以及如何放大的。首先,我們需要產生短脈衝激光光束作為種子光,然後讓它經過多級放大。實際上會有兩個脈衝——預脈沖和主脈衝。預脈衝首先擊中錫珠,使它變成正確的形狀;然後主脈衝將壓扁的錫珠轉化為等離子體,從而發射出珍貴的 EUV 光。
這裡的難點在於放大階段會不斷增加它的功率,但必須確保兩個光束在錫珠上有正確的光學性能,尤其是正確的聚焦。每束脈衝激光都由非常微小的、緊湊的光粒子組成,緊緊地拋向錫珠。為了正確地擊中它們的目標,它們必須在正確的瞬間到達,不能過早或過晚;否則,衝擊力將無法壓平錫珠。在最壞的情況下,第二道激光脈衝射出的子彈沒有擊中目標, EUV 就會失敗。強調一下,以上過程要做到每秒鐘進行五萬次,為了讓激光束以極大的功率穩定傳輸,系統的複雜性可想而知。
一家鮮為人知的廠商——德國通快(TRUMPF)正是背後的一個重要玩家。據介紹,他們在 EUV 曝光激光發生系統上投入了超過 15 年。針對 EUV 曝光機,TRUMPF 開發了一種激光器,可產生 40 千瓦的脈衝輻射,重複率為 50 千赫。該激光器有兩個播種器和四個放大級,體積非常大,必須放置在 EUV 機器下面的一個獨立樓層。
相關資料顯示,如上圖所示, EUV 激光系統由大約 45 萬個零件組成,重約 17 噸。為了確保這些零件正確組裝,僅檢查標準就多達 1000 多條,這還不包括模組和子模組額外的預檢標準。而從種子光發生器到錫珠有 500 多米的光路,這對所有零組件都提出了非常苛刻的要求,尤其是系統中包含的 400 多個光學元器件。由此也看到通快在這方面的實力。
在通快的幫助下,總部位於聖地牙哥的Cymer成為了 EUV 光源系統最後的贏家。維基百科的資料顯示,Cymer 由Robert Akins 博士和 Richard Sandstrom 博士於 1986 年創立,他們於 1970 年代中期在加州大學聖地牙哥分校的實驗室課堂上相識。 1986 年,個人電腦市場為 Akins 和 Sandstrom 將他們獨特的激光知識應用於半導體曝光技術打開了大門。 1988 年,Cymer 推出了用於高級研發應用的第一個光源,以支持半導體曝光技術的發展。 1990 年,第二代光源出貨,公司發展迅速, 1988 年至 1994 年共出貨 78 套光源系統。
2009 年 6 月,Cymer 將世界上第一個完全集成的 LPP EUV 曝光光源運送到荷蘭 Veldhoven 的 ASML ,以集成到其 EUV 曝光機中。 2012 年 10 月,荷蘭半導體設備製造商 ASML 宣布將收購 Cymer,作為其 EUV 設備戰略的一部分。至此,一場 EUV 曝光機的攻堅戰告一段落。
寫在最後
從 EUV 曝光機的發展,我們可以看到在聰明的人類的推動下,很多看起來似乎不可能的任務,也變成了可能。我們從中也意識到,任何一個龐大複雜的系統,都需要多個領域頂尖的供應商攜手合作,才能完成,光是靠其中的一兩家公司,是不可能讓科技繼續往前推進。由此,我們也看到了全球供應鏈協作的重要性。
《虎嗅網》授權轉載
【延伸閱讀】


